Ausstattung
Lithographie
Zeiss NVision 40 High End Cross Beam
- Elektronensäule: hochauflösende (1,3nm) Feldemission
- Ionensäule: hochauflösend (4nm), geeignet für Deposition und Ätzen
- Herstellung von TEM-Proben und Analyse in Transmissio
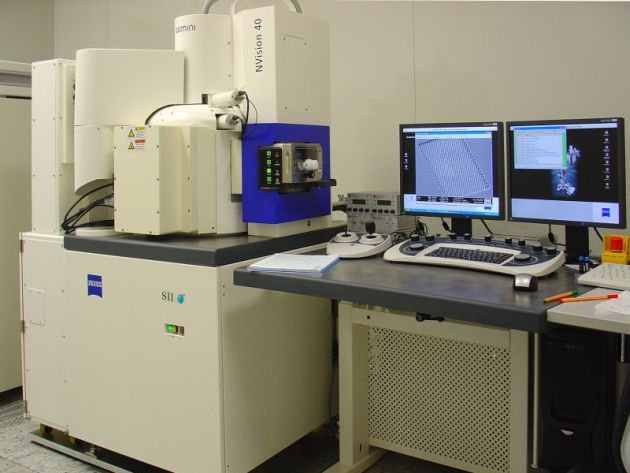
Raith eLine Elektronenstrahllithographie
- hochauflösend bis <20nm Strukturbreite
- 100 x 100 mm interferometrisch gesteuerter Tisch
- Positionsgenauigkeit 2nm in x- und y-Richtung
- Strahldurchmesser : 1,6nm
- Stitching freie Belichtung durch FBMS (Fixed Beam Moving Stage) & MBMS (Modulated Beam Moving Stage)

Karl Süss MA4 Maskaligner
- bis zu 4"-Substrate, bis zu 7"-Masken
- Auflösung: Standard 800nm, Optional bis 300nm

EVG Al-4 Maskaligner
- bis zu 4"-Substrate, bis zu 5"-Masken

Epitaxieanlagen
8'' Doppelkammer-Molekularstrahl-Epitaxieanlage (Dr. Eberl MBE-Komponenten GmbH)
- Gekoppelte Anlagen für III-V Halbleiter & SiGe Schichtsysteme
- Semiautomatischer Probentransfer über zentrale Kammer, Wassertoff- Cracker (H)
- Sehr gute Schichtdickenhomogenität, Temperaturhomogenität und Dotierhomogenität
- Ultra Hoch Vakuum (10E-10 - 10E-11 mbar)
- In-situ-Kontrolle mittels RHEED
- Materialien Reactor C: Ga, In Al, As2, P2, Si, Be
- Materialien Reactor D: Si, Ge, B, P

Varian Gen II Modula MBE
- gekoppelte Anlagen für GaAs und InP Schichtsysteme
- Schichtdickengenauigkeit im sub-nm Bereich
- In-situ-Kontrolle mittels RHEED / Ultra Hoch Vakuum ( 10E-8 - 10E-10 mbar )
- Materialien : Ga, In, Al, As2, Si, Be
- Reaktor A: Silizium E-Beam-Verdampfer, Wasserstoff-Cracker (H)
- Reaktor B: Phosphor-Cracker

Bluwave HFCVD
Heißdraht-aktivierte Gasphasenabscheidung
- Prozessgase: Methan (CH4), Wasserstoff (H2), Stickstoff (N2)
- Materialien: Poly- und nanokristalline Diamantfilme (PCD, NCD)
- Abscheidung von Diamantfilmen sowie das Überwachsen von Diamantsubstraten

AsTex MWCVD
MicroWave Plasma Chemical Vapour Deposition
- Prozessgase: Methan(CH4), Wasserstoff(H2), Stickstoff(N2), Argon(Ar), Sauerstoff(O2)
- Material: Poly- und Nanokristallindiamantschichten (PCD und NCD)

Deposition
Roth ß Rau Ionsys 1000 IBD
Ion Beam Deposition
- Reinraumklasse 1
- Multischichtsysteme (DBR,VCSEL,etc.)
- In-situ-Kontrolle
- Material: Metalle(z.B. Al,Zr,Cr), Oxide(z.B.ITO,TiO,SiO2), Nitride(z.B.Si2N3)
- Prozessgase: Argon(Ar), Xenon(Xe), Sauerstoff(O2), Stickstoff(N2)
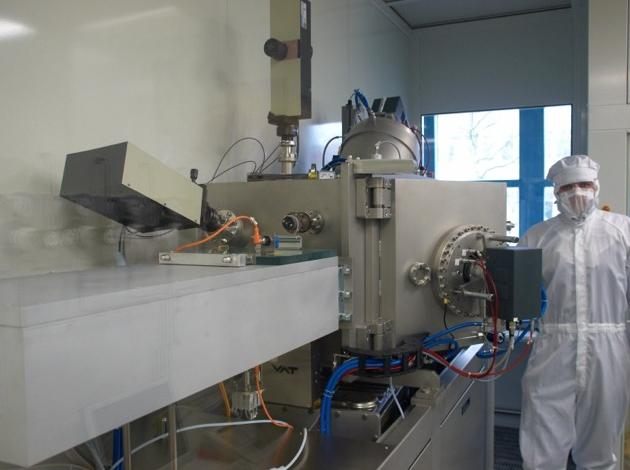
Pfeiffer PLS 500 Aufdampfanlage
- Elektronenstrahl oder thermisch
- Material: Titan(Ti), Nickel(Ni), Chrom(Cr), Platin(Pt), Aluminium(Al)

Balzers BAK 600 Aufdampfanlage
- Elektronenstrahl oder thermisch
- Prozessgas: Argon (Ar)
- Material: Nickel (ni), Titan (Ti), Platin (Pt), Gold (Au), Germanium (Ge), Chrom (Cr)

Oxford Plasmalab 80 PECVD
Plasma Enhanced Chemical Vapour Deposition
- Prozessgase: Silan (SiH4), Wasserstoff (H2), Ammoniak (NH3), Distickstoffoxid (N20)
- Material: Siliziumnitrid (SiN), Siliziumoxid (SiO), Silizium (Si)
Emitech K550 Sputter Coater
- Prozessgase: Argon (Ar)
- Material: Platin (Pt)
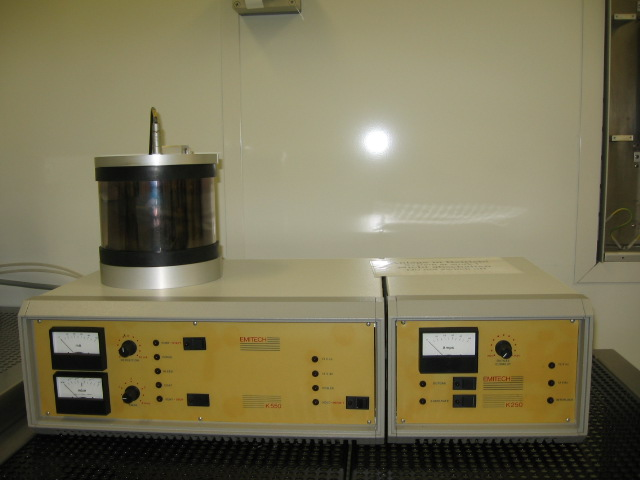
Trockenätzanlagen
2 Oxford Plasmalab 100 ICP-RIE
Inductive Coupled Plasma - Reactive Ion Etching
- ICP 1: mit Fluordonatoren für das Silizium-Tiefätzen (Bosch-Prozess)
- ICP 2: mit Chlordonatoren für das Ätzen von Halbleitermaterialien (z.B. GaAs)

Castor und Pollux RIE
Reactive Ion Etching
Parallelplattenreaktor
- Prozessgase: Trifluormethan(CHF3), Schwefelhexafluorid(SF6),Sauerstoff(O2)
- Material: Siliziumnitrid(SiN), Siliziumoxid(SiO)

Oxford Plasmalab 80 Plus RIE
Reactive Ion Etching
Parallelplattenreaktor
- Prozessgase: Wasserstoff(H2), Methan(CH4)
- für: Indium(In)-,Phosphor(P)-,Gallium(Ga)-,Arsen(As)-Verbindungshalbleiter (z.B. InP)

Plasmalab RIE
Reactive Ion Etching
- Ätzen von BCB, SiN, SiO2, Si
- Gase: CHF3, Ar, SF6, O2

TePla 200-G Plasmaverascher
- Zum Ätzen von Fotolacken und organischen Rückständen
- Prozessgas: Sauerstoff (O2)

Weitere Geräte
Xerion RTA
Rapid Thermal Annealing
- Prozessgas: Argon (Ar)
- Temperaturen bis 400°C
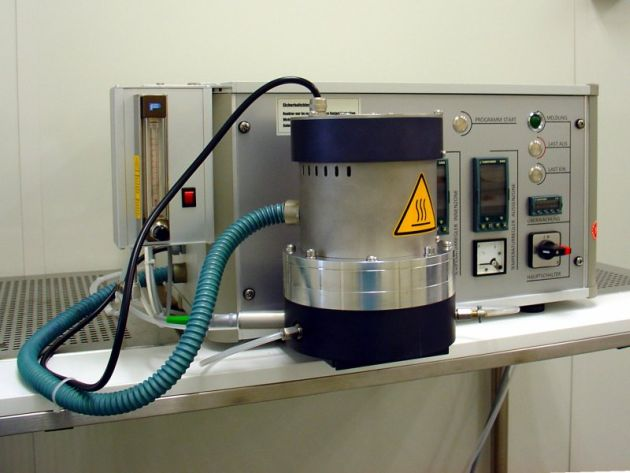
RTA
Rapid Thermal Annealing
- Prozessgas: Argon (Ar), Stickstoff (N2)
- Temperaturkontrolle mit Thermoelement oder Pyrometer
- Temperaturen bis 1300°C

Bal-Tec CPD 030 Kritisch-Punkt-Trockner
Prozessgas: Kohlendioxid (CO2)

Analytik
AFM Nanoscope Dimension 3100
- Atomic Force Microscopy with Contact- and Non-Contact-Modus
- Wafer up to 6" diameter

AFM CP-II
- Rasterkraftmikroskopie (AFM) im Contact- und Non-Contact-Modus
- Rastertunnelmikroskopie (STM)
- Nanolithographie

DualScopeTM 95 SPM System
- DualScopeTM 95 SPM Scanner bietet die Einrichtungen für alle SPM-Modi.
- Integrierte Elektronik garantiert niedrigsten Rauschpegel in elektrischen SPM-Modi.
- Unterstützte Modi: Kontaktmodus (DC), intermittierenden Modus (AC), Nicht-Kontakt-Modus, Frequenzmodulationsmodus, Querkraft-Modus, Kraft-Spektroskopie, EFM, MFM, STM
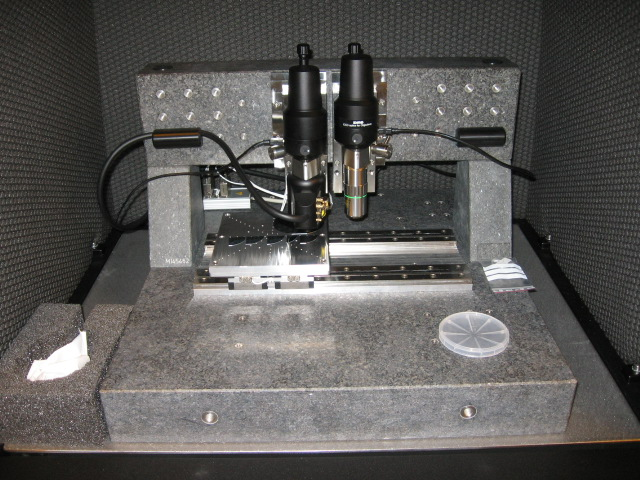
2 Scanning Electron Microscopes / Hitachi s-4000 und s-4100
- Auflösung: 1,5nm bei 30kV, WD 5mm
- Vergrösserung: 20x bis 300000x
- Beschleunigungsspannung: 0,5 bis 30kV
- s-4000: Aktives Bildverarbeitungssystem DISS 5
- s-4100: Energiedispersives Spektrometer EDAX DX-4, Backscattered electron detector

Spektroskopie-Messplatz
Absorptions- und Photolumineszenz-Spektroskopie
- Temperatur regelbar bis 10K
- Sub-nm spektrale Auflösung
- Si-Photodiode und InGaAs-Diode für Wellenlängen bis ins Infrarote
- Lock-In Detektion
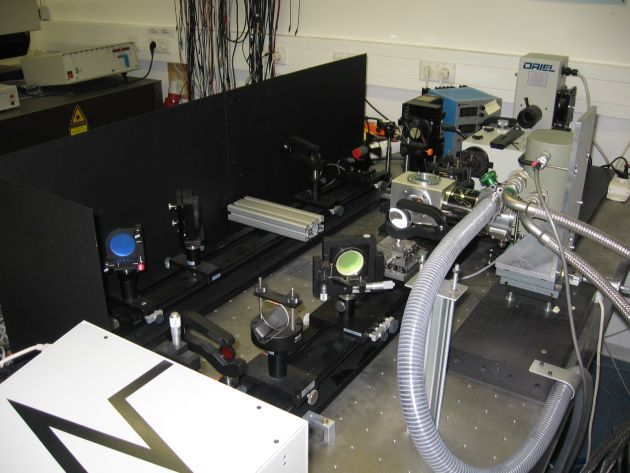
Mikro-Photolumineszenz-Spektroskopie
- hochauflösender 1m-Czerny-Turner-Monochromator
- stickstoffgekühlte CCD-Kamera (deep depletion, anti-etaloning)
- Kryostat gekühlt mit flüssigem Helium, Temperaturen von 3,5K-475K
- hochauflösende Positionsgenauigkeit von 0,1µm
- Mikroskopobjektiv mit 0,7µm Auflösung
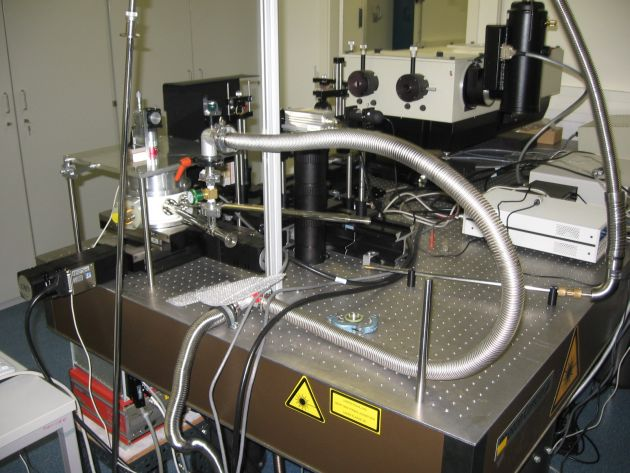
Laserdioden-Messplatz ( gepulst )
- Treiberstrom bis 2A
- 500ns Pulsdauer, 1ms Pulsabstand (Tastverhältnis: 0,5)
- Temperatur variabel von -10°C bis 150°C
- Ultraschnelle InGaAs- und Si-Photodioden zur Detektion (Anstiegszeit: 5ns)
- Fernfeldmessung für x- und y-Achse
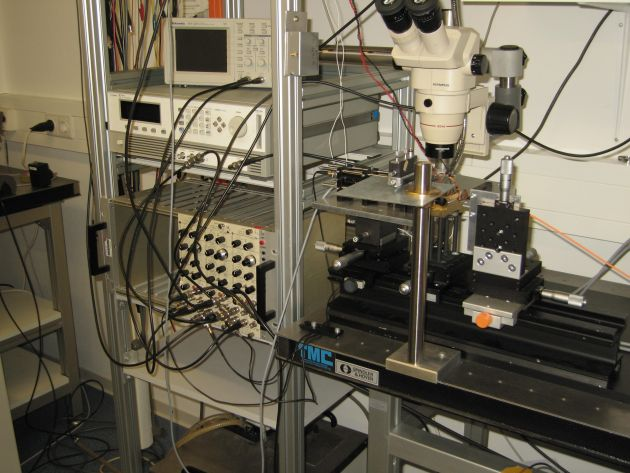
Laserdioden-Messplatz ( cw )
- Treiberstrom bis 500mA, 10µA Auflösung
- Multisektionslasermessung (3 Nadeln)
- Temperatur variabel von -10°C bis 150°C

Laserdioden-Messplatz ( high power cw )
- Treiberstrom bis 40A, Auflösung 10mA
- Komplette Laserdioden Charakterisierung Io,Vf und Po
- Temperaturkontrolle -50°C bis 150°C, Genauigkeit +/-0,1°C
- Wärmesenke integriert

Optischer Spektrumanalysator
- Wellenlängenbereich von 600nm - 1700nm
- Hohe Auflösung von 0,02nm
- Geeignet für DWDM-Netzwerkanalyse
- Umfangreiche Analyse- und Fittingfunktionen (Power,WDM,SMSR,etc.)
- 7 unabhängige Messspuren

Phillips PW 3710 MPD Röntgendiffraktometer
- Hohe Auflösung ( Dicke, Verspannung, Versetzungen )
- 3-Achsen Geometrie
- Pulver messbar
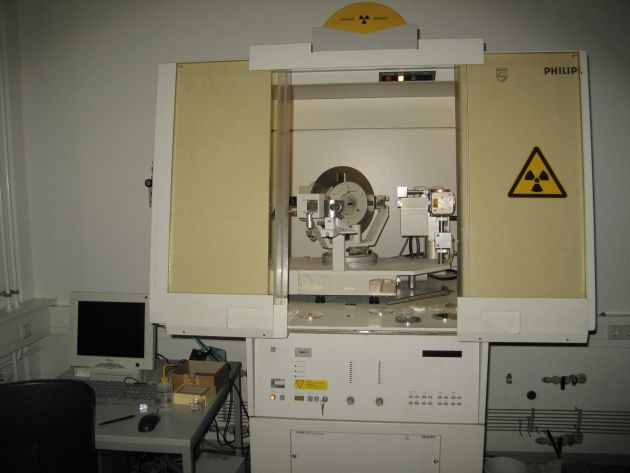
PANalytical X’Pert Pro MRD
-Offene Eulerwiege mit XYZ-Probentisch
-Rocking curve-/ Triple Axis-Sekundäroptik
-Hochauflösungs- , Textur-, Spannungs- und Reflektivitätsmessungen (Auflösung von 0,0001°)
-Hochauflösendes Mapping im reziproken Raum, Akzeptanzwinkel 12‘‘

Sloan Dektak IIA Profilometer
- 20nm Auflösegenauigkeit

Leica DMR Mikroskop
- bis 1000fache Vergrößerung
- Kontrastverfahren: Hellfeld, Dunkelfeld, Differentieller Interferenzkontrast
- Auflicht und Durchlicht

Plasmos SD-2100 Ellipsometer
Schichtdickenmonitoring transparenter Schichten

Zygo New View 5000 Weißlichtinterferometer
- Vertikale Auflösung bis zu 0,1nm
- Objektive: 5xMichelson, 50x Mirau
- Stitching-Möglichkeit durch xy-motorisierten Probentisch
- Erweiterter vertikaler Scanbereich bis zu 20mm

Ambios Technology Oberflächenprofilometer XP-100
- 3 nm-Auflösegenauigkeit
- 0,03-10 mg Stylus-Aufdruckkraft
- 1,2 mm. max Messbereich in z-Richtung
- Analyse von Stufenhöhen, Schichtdicken, Rauheit, Welligkeit, Dünnschichtstress